近期半导体行业出现显著动向,包括美满电子科技、谷歌、Meta与联发科在内的多家科技巨头纷纷对英特尔开发的EMIB先进封装技术表现出浓厚兴趣。这种趋势预示着未来可能形成"前端晶圆制造交由台积电完成,后端封装测试转向英特尔"的全新产业协作模式。
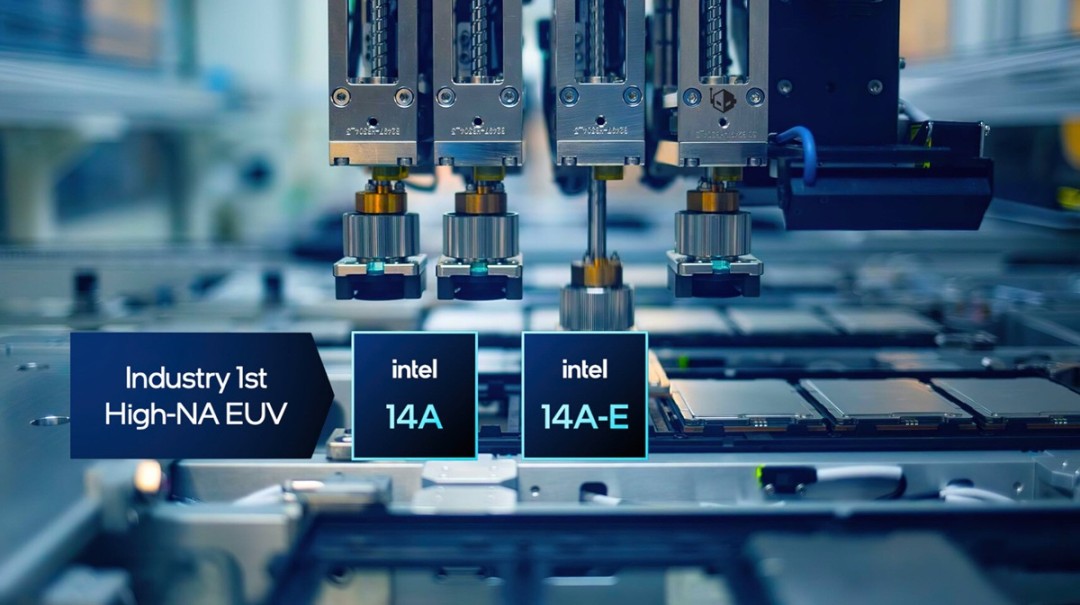
行业分析指出,英特尔提供的EMIB封装方案有望替代台积电当前广泛采用的CoWoS封装技术。这一转变主要源于市场现状——台积电的封装产能持续紧张,已难以满足日益增长的市场需求。值得注意的是,苹果与高通近期发布的招聘信息中,都明确要求应聘者需掌握英特尔EMIB先进封装技术的专业知识。
根据权威科技媒体TECHPOWERUP的报道,苹果公司已启动对英特尔封装工艺流程的全面评估,积极寻求替代性的封装解决方案。作为长期合作伙伴,博通协助苹果设计的"Baltra"AI芯片原计划采用台积电CoWoS封装,但受限于产能瓶颈,双方已开始将EMIB封装作为重点考虑选项。
值得关注的是,苹果与英特尔的合作范围正持续扩大。除先进封装领域外,双方在晶圆代工方面也取得实质性进展。据知情人士透露,苹果最快将于2027年采用Intel 18A-P制程工艺生产面向MacBook Air和iPad Pro的入门级M系列芯片。目前苹果已通过保密协议获得18AP PDK 0.9.1GA技术资料,正等待英特尔在2026年第一季度正式发布18AP PDK 1.0/1.1版本。
与此同时,供应链消息证实英伟达和AMD也在积极评估Intel 14A制程工艺的可行性。业内专家分析认为,随着芯片设计公司对先进封装技术的依赖度不断提升,封装产能已成为制约芯片生产的关键环节之一。在此背景下,将先进制造工艺与封装技术进行整体考量的策略,不仅有助于企业分散供应链风险,更能确保产品供应的稳定性与可靠性。



















